Two Types of New Precision Processing Tools which Support Thinning for Advanced Semiconductor Devices
DISCO CORPORATION (Head Office: Ota-ku, Tokyo; President: Kazuma Sekiya) has developed the GFCP series of grinding wheels and the DPEG-BP dry polishing wheel: grinding wheels for semiconductor package grinding, and a dry polishing wheel for the backside polishing of Si wafers with high bumps. These wheels will be exhibited in SEMICON Japan 2017 held at Tokyo Big Sight from December 13 to 15. The wheels will be released sequentially beginning in 2018.
In recent years, demand for semiconductors in high-performance electronic devices including smartphones is increasing. In order to correspond to this growing need for packaging technology, WLCSP (Wafer-Level Chip Size Package) technology is widely adopted. The GFCP series of grinding wheels and the DPEG-BP dry polishing wheel are the optimal precision processing tools for WLCSP production.
GFCP Series of Grinding Wheels for Package Grinding
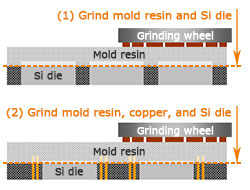

Developmental Background
During package grinding for FOWLP (Fan-Out Wafer Level Package), a type of WLCSP, various materials
with different grinding performances are processed, such as Si die, copper metal, mold resins, and
insulating films (polyimide). Up until now, it was difficult to perform stable grinding on these
materials simultaneously while preventing burring in the ductile materials, such as copper and resin.
Features
The GFCP series adopts porous vitrified-bonded wheels, which are excellent for ductile materials.
Furthermore, by strictly controlling the hardness of the wheels, the technology can be used to process
multiple types of package configurations and materials in order to meet the customer’s needs.
DPEG-BP Dry Polishing Wheel for High Bump Wafers
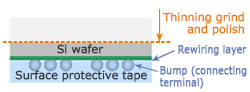

Developmental Background
In the thinning of WLCSP with bumps 100 µm and taller, it is common to perform grinding and polishing
while absorbing the bumps by mounting a thick surface protective tape and controlling wafer
unevenness. After wafer grinding, in order to enhance the strength, it is necessary to remove
distortions on the ground surface generated by polishing. However, if the distortion is eliminated
completely, the gettering effect* is lost and wafer failure is likely to occur due to heavy metal
contamination.
Although DISCO has already developed the DPEG series of dry polishing wheels which can polish while
maintaining the gettering effect, in some cases, polishing failures may occur in wafers with a thick
surface-protective tape because the heat generated during processing cannot escape.
※Gettering effect: Forming crystal defects and distortions (= gettering site) on the backside of a Si wafer, capturing the impurities which cause metal contamination and affixing them to the getting site. Gettering DP wheels form a gettering site with minor scratches on the backside of the wafer and capture the heavy metal contamination.
Features of This Product
The DPEG-BP dry polishing wheel can control heat generation even when polishing bump wafers mounted on
a thick surface-protective tape, achieving stable processing. Furthermore, just like the existing DPEG
series of dry polishing wheels, the DPEG-BP polishing wheel achieves both a high die strength and a
gettering effect.
Schedule
Start of sales
| GFCP Series of Grinding Wheels | January 2018 |
|---|---|
| DPEG-BP Dry Polishing Wheel | April 2018 |
Contact
Please feel free to contact us with any questions or inquiries.
