先端半導体デバイスの薄化に対応する精密加工ツール2種を製品化
半導体製造装置メーカー・株式会社ディスコ(本社:東京都大田区、社長:関家一馬)は、半導体パッケージ研削向けグラインディングホイール「GFCPシリーズ」、およびハイバンプ付Siウェーハの裏面研磨向けドライポリッシングホイール「DPEG-BP
type」を開発しました。これらはSEMICON Japan 2017(12/13-15:東京ビッグサイト)に出展し、2018年に順次販売開始します。
近年、スマートフォンなど高機能電子機器向けの半導体デバイスに対し、薄型化・小型化のニーズが高まっています。このニーズに対応するパッケージング技術としてWLCSP(Wafer Level Chip Size
Package)の採用が増加しています。「GFCPシリーズ」「DPEG-BP type」はWLCSP生産に最適な精密加工ツールです。
パッケージ研削向けグラインディングホイール「GFCPシリーズ」
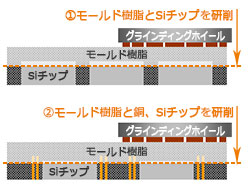

開発の背景
WLCSPの一種であるFOWLP(Fan-Out Wafer Level
Package)におけるパッケージ研削の場合、研削対象にはSiチップ、銅、モールド樹脂、絶縁膜(ポリイミドなど)など研削性の異なるさまざまな素材が含まれています。これら素材を同時にかつ安定して研削し、銅や樹脂など延性材料のバリ発生を抑えることが困難でした。
特徴
GFCPシリーズでは延性材料の研削性にすぐれた有気孔のビトリファイドボンド砥石を採用しました。また、砥石の硬度を厳密にコントロールすることで、顧客要求に応じた様々なパッケージ構造・材料に対応可能となりました。
ハイバンプ付ウェーハ向けドライポリッシングホイール「DPEG-BP type」
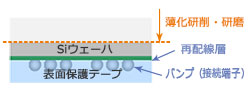

開発の背景
ウェーハ上に100
µm以上のハイバンプが形成されているWLCSPの薄化では、厚い表面保護テープを貼ることでバンプの凹凸を吸収し、ウェーハの変形を抑えながら研削・研磨することが一般的です。ウェーハ研削後は強度を上げるため、研削面にできた歪みを研磨して除去する必要がありますが、完全に歪みを除去するとゲッタリング効果※が失われ、重金属汚染によるウェーハの特性不良が生じる可能性があります。
当社は既に、ゲッタリング効果を維持しながら研磨が可能なドライポリッシングホイール「DPEGシリーズ」を展開していますが、厚い表面保護テープが貼られているウェーハでは、加工時に発生する熱が逃げにくくなり、研磨不良を誘発させるケースが出てきています。
※ゲッタリング効果:Siウェーハ内部または裏面に、結晶欠陥・歪みなど(=ゲッタリングサイト)を形成し、このゲッタリングサイトに金属汚染を引き起こす不純物を捕獲・固着する技術。ゲッタリングDPホイールは、ウェーハ裏面の微小な傷でゲッタリングサイトを形成し、重金属不純物を捕獲します。
本製品の特徴
DPEG-BP
Typeは厚い表面保護テープが貼られたバンプ付きウェーハを研磨する際も、発熱を抑えることができるため、安定した加工が可能です。また、従来のDPEGシリーズ同様の高い抗折強度とゲッタリング効果の両立を実現しています。
今後の予定
販売開始
| GFCPシリーズ | 2018年1月 |
|---|---|
| DPEG-BP type | 2018年4月 |
お問い合わせ
株式会社ディスコ 広報室
