小チップデバイスの分割性を向上
Φ300 mmウェーハ対応フルオートマチックエキスパンダ「DFX2400」を開発
半導体製造装置メーカー・株式会社ディスコ(本社:東京都大田区、社長:関家一馬)は、Φ300 mmウェーハ対応フルオートマチックエキスパンダ「DFX2400」を開発しました。本装置はSEMICON Japan 2017(12/13-15:東京ビッグサイト)に初出展します。
開発の背景
スマートフォンをはじめとするモバイル機器では、搭載される半導体デバイスのチップサイズが小型化しています。今後IoT向けセンサの増加により、小チップ品の生産はさらに増えることが見込まれ、そのダイシングにはレーザを使ったステルスダイシング(SD)が有効です。SD後にはダイシングテープを拡張(エキスパンド)し、チップ分割しますが、次のダイボンディング工程に必要なカーフ幅を保持する必要があります。
一方、液晶や有機ELのディスプレイドライバICはチップサイズのタテヨコ比が大きく、分割ライン数が大きく異なるため、従来方式ではチップ短辺方向のカーフ幅が十分取れず、ダイボンディング時のピックアップ不良の懸念がありました。
「DFX2400」では新開発のエキスパンド方式を採用し、カーフ幅の制御性が向上します。
DFX2400の特徴
2方向(XY)エキスパンド方式の採用
- テープフレームへの貼付前に、ダイシングテープをX方向、Y方向個別に引き伸ばし
- チップサイズや形状に合わせたエキスパンド制御が可能で、特に長尺チップに有効
- ダイシングテープの幅方向とロール方向で伸び率が異なる場合も、それぞれに合わせたエキスパンド制御が可能
- エキスパンド後のたるみのない状態でテープフレームへ貼付を行うため、ヒートシュリンク※が不要
- 装置サイズ:W1,560 x D3,833 x H1,800 mm
※ダイシングテープのたるみを除去するため、温風などで熱してテープを収縮させること
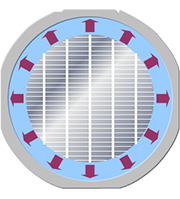
引き伸ばし量 均一
↓
チップ間隔 不均一
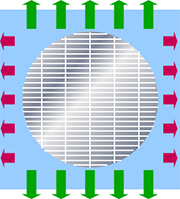
チップ短辺方向引き伸ばし量 大
チップ長辺方向引き伸ばし量 小
↓
チップ間隔 均一
今後の予定
| 2017年12月 | SEMICON Japan 2017 出展 |
|---|---|
| 2018年夏 | 販売開始 |

お問い合わせ
株式会社ディスコ 広報室
