對應多樣化的封裝研磨需求
全自動研磨機「DFG8020」「DFG8030」
2機種同時上市
半導體機台製造商・株式會社DISCO(總公司:東京都大田區,社長:関家一馬)開發了2種能對應多樣化封裝研磨需求的全自動研磨機機型。分別是能對應最大390×390 mm尺寸的面板等級封裝需求「DFG8020」,與能對應Strip(短冊型基板)的「DFG8030」將會同時上市。兩機種也將於SEMICON Japan Virtual中展出。(2020年12月14日~17日)。


開發背景
5G服務開始後,以智慧型手機為首的高端終端消費商品數量增加。高週波(RF)模組或電力管理等所相關FOWLP※1或PLP※2等高密度封裝的採用,封裝的薄化及以形成配線層為目的的研磨需求便隨之越來越高。
此外,在WLP※3或PLP等的封裝製程中,樹脂封裝時的形狀呈現圓形或四方形等多樣化的形狀,包含現有的長條狀基板・Strip在內,皆需要研磨機台能彈性對應。
為了對應這些需求,故開發了能對應最大390×390 mm尺寸的封裝研磨機「DFG8020」,Strip的高生產量加工研磨機「DFG8030」。
※1 Fan Out Wafer Level Package:將切割後的晶粒排列在晶圓片上,並從晶片端點拉出配線於晶片外側形成重分佈層,藉以實現多晶片腳數等的封裝手法
※2 Panel Level Package:將複數的IC或電子零件等排列或堆積在1個四方形面板(Panel)內的封裝手法
※3 Wafer Level Package:將切割前的晶圓片或將切割後的晶粒排列在晶圓片上再一次一起封裝的手法
產品特徵
DFG8020/DFG8030共通
- 從工作物的進片到加工,洗淨,晶片盒的收納為止都用全自動進行
-
2 Spindle・2 Chuck table構造
工作流程 例
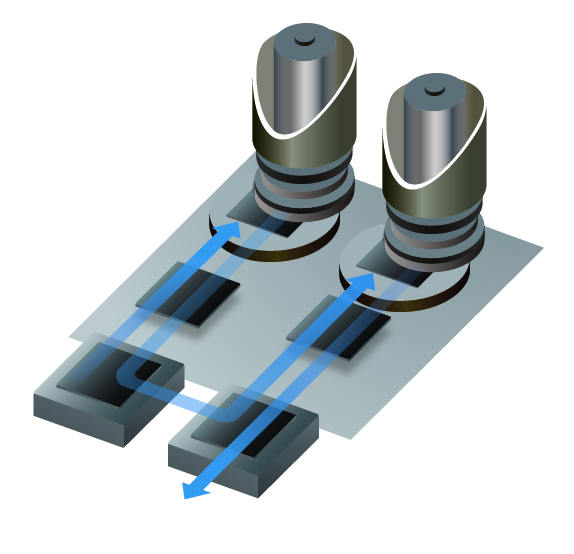
2軸加工(粗加工研磨→精加工研磨等) 
單軸・並行的加工 -
透過加工點的最佳化以達到高平坦度研磨
- 想定使用大直徑Φ500 mm研磨輪的設計,進而確保加工軸的剛性・穩定性
- 抑制工作物表面的平坦度不規則性
-
可切換研磨方式
- 經由Chuck table及研磨輪兩者旋轉的In-feed研磨
- 經由將工作物送往旋轉中研磨輪的Creep-feed研磨
DFG8020
對應Panel size的全自動研磨機
- 對應最大390×390 mm工作物,Φ300 mm 用鐵圈(Tape Frame)※4
-
size・重量
W1,660 × D4,400 × H1,800 mm,約5,700 kg
DFG8030
具備strip用搬送構造的全自動研磨機
- 對應寬45~100 mm,長100~300 mm的strip及小半徑晶圓片※5
-
對應複数工作物的同時研磨以達高產能加工

- 經加工中的非接觸厚度測量※5以隨時控制適切的研磨量
-
size・重量
加工部:W1,660 × D2,300 × H1,800 mm
搬送部:W2,500 × D1,500 × H1,800 mm
重量:約5,950 kg(加工部・搬送部計)
※4:特殊對應
※5:選配
今後的預定
| SEMICON Japan Virtual 2020出展 | 2020年12月14日~17日(至2021年1月15日為止可閲覧) |
|---|---|
| Test cut | 可接受試切要求 |
| 預定開始販賣 | 2021年 9月 |
關於株式會社DISCO
提供半導體‧電子零件的製造所使用的切割、研磨等精密加工機台、及安裝於機台的精密加工工具的半導體機台製造商。經由活用附加在這些產品之上的解決方案及追求的技術以提供最適的加工,目前被廣傳於國內外電子產品元件製造商及半導體代工製造企業等,弊司的產品‧加工技術亦被廣泛採用。詳情請見官網www.disco.co.jp。
