プラズマダイシング加工
ソリューション
プラズマダイシングは、真空下でドライエッチングをおこなうことでウェーハをチップ化(個片化)する加工技術です。プラズマダイシングにおいて使われるBoschプロセス※(図参照)は、高速かつ高アスペクト比、狭ストリートでのチップ化を実現します。
ディスクリートデバイスやRFIDなどではウェーハ1枚あたりのチップ取り個数を増やすため、狭ストリート化が進んでいます。また、モバイル機器やIoT向けに需要が高い小チップデバイスにおける高い生産性がこれまで以上に求められています。さらに、ゼロディフェクトを求められる車載半導体など高品質な加工が要求されるデバイスにもプラズマダイシングは対応可能です。
※ドイツRobert Bosch GmbHによって1992年に開発された手法
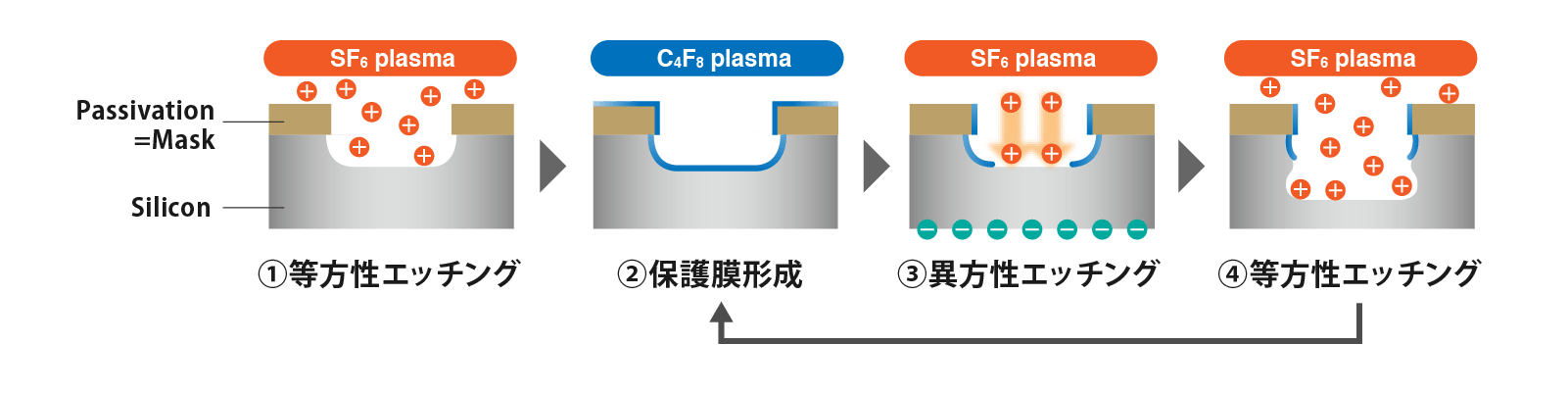
プラズマダイシングのメリット
小チップデバイスの生産性向上
ウェーハ上の全カットラインを同時に加工するため、小チップデバイスでも高いUPHを維持します。狭ストリート化にも対応可能なためチップ取り個数のUPが可能です。-
さまざまな形状への加工に対応
ドライエッチングによる加工のため、マスクパターンに応じた形状でのチップ化が可能です。
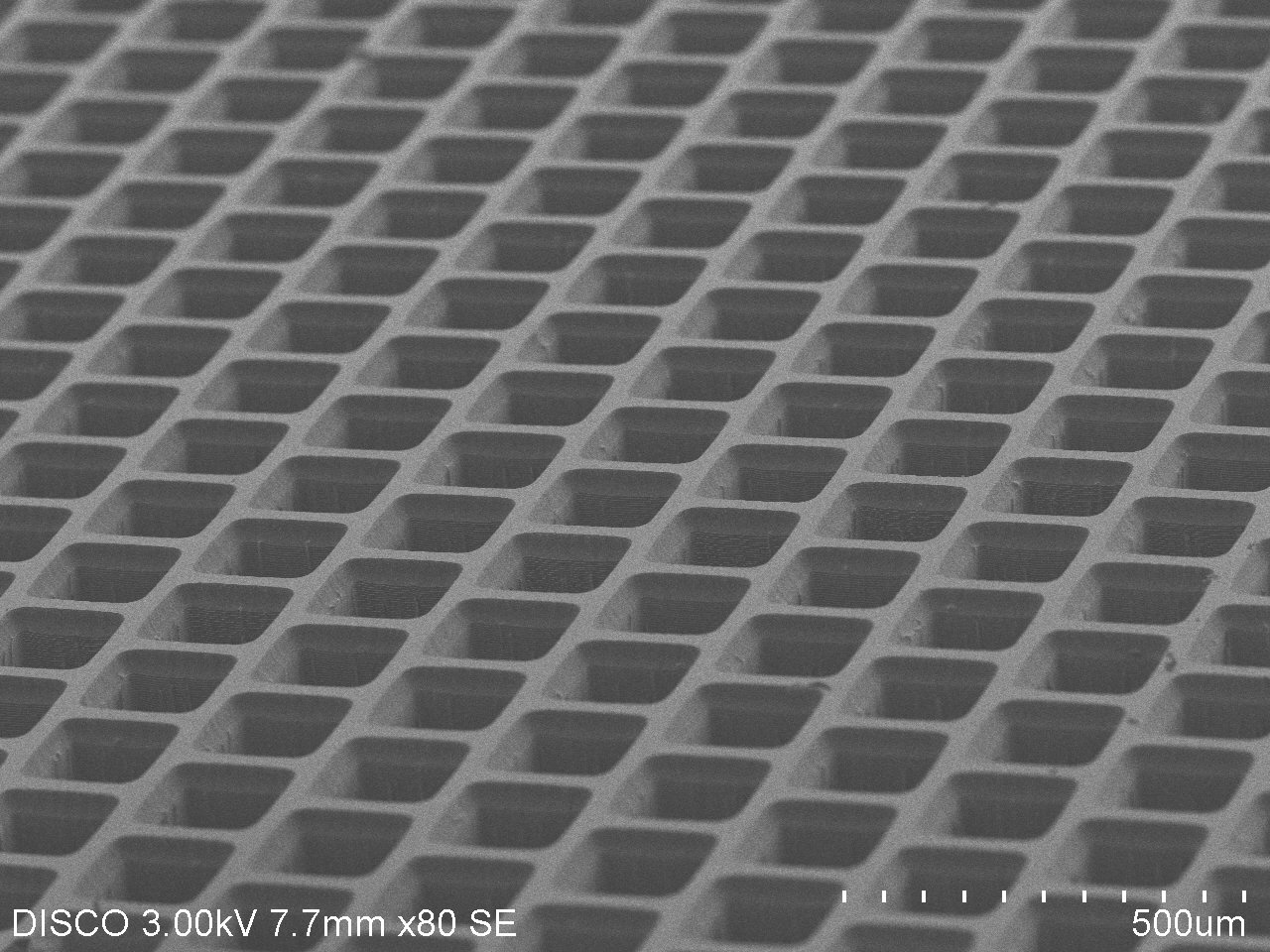

ハイクリーンプロセス
プラズマダイシングは機械加工ではなく化学反応によるドライエッチングプロセスであるため、加工屑や溶融デブリなどの発生がありません。チップ強度の向上
機械的ダメージがなく、熱的影響が少ないプラズマダイシングを用いることで、チップ強度の向上が可能です。
アプリケーション
ディスコが提供可能なトータルソリューション
通常のデバイスでは、ストリート上にプラズマダイシングの阻害となる膜やメタルなどが存在します。そのためプラズマダイシングの前処理として、それらを除去する工程が必要となります。
そこで当社が培ってきた様々な加工技術、アプリケーションによりデバイス形成後のSiウェーハを個片化するまでのプロセスをワンストップで提供いたします。
アプリケーション例
ストリート上にメタルが形成されたSiウェーハの個片化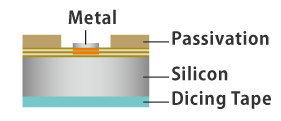
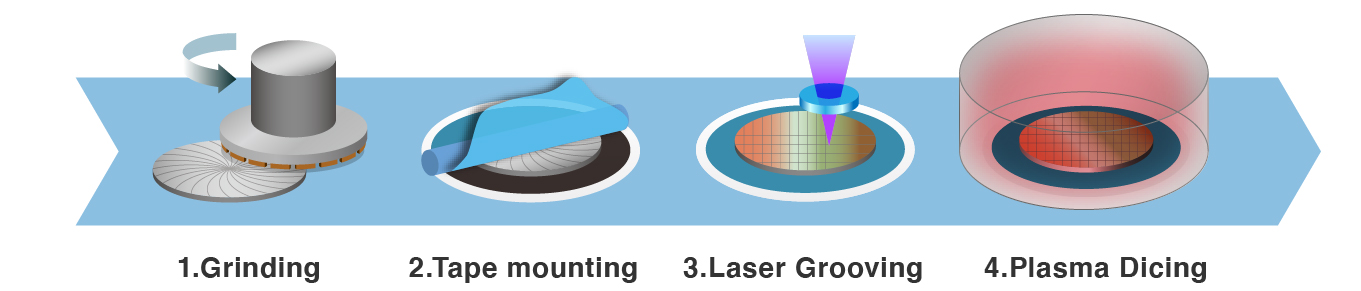
- 裏面研削:バックグラインダ/ポリッシャでウェーハを薄化
- テープマウント:ハンドリングが難しい薄ウェーハをマウンタにてテープフレームへ貼り付け
- レーザグルービング:レーザソーにてストリートライン部分のパッシベーション膜やTEGなどのメタル部分を除去
- プラズマダイシング:テープフレームにマウントされた状態のままプラズマダイシングを実施
アプリケーション採用実績
- Power device
- LED
- RFID
- RF filter
- MEMS
- TVS(ツェナーダイオード) など
米国Plasma-Therm社との業務提携

当社は、米国Plasma-Therm社と2016年4月に業務提携契約を締結し、同社のプラズマダイシング装置を用いたR&D、テストカット、装置販売およびアフターサポートなど、グローバルにサービスを提供しています。
お問い合わせ
ご質問・ご相談等ございましたら、お気軽にお問い合わせ下さい。


