DBG+DAF激光切割
解决方案
DBG(Dicing Before
Grinding)*1工艺利用研削来分割芯片,故能够降低背面崩裂,并能因此提高芯片抗折强度。另外,因为是在研削结束阶段分割成芯片,所以有望在加工薄形芯片时减小晶片破损的风险。今后如能在这种DBG工艺中采用DAF(Die
Attach Film)*2的话,也有可能在SiP(System in Package)等薄型芯片的叠层封装制造方面全面采用DBG工艺。
在DBG工艺中采用DAF时,需要在分割成芯片的晶片背面贴上DAF,并再次将DAF单独切割。这次我们向大家介绍利用激光全自动切割DAF的应用技术。
*1 DBG (Dicing Before Grinding) : 这种技术将传统的“背面研削→晶片切断”的工艺倒过来,先将晶片半切割,然后利用背面研削进行芯片分割。
*2 DAF (Die Attach Film) : 这是一种薄膜状的接合材料,用于薄型芯片叠层等。
应用技术
在DBG加工后,用磨轮刀片来切割DAF时,目前以下几个方面的课题有待解决。
DBG工艺中利用磨轮刀片切割DAF时的课题
- 芯片的整列性
粘贴切割胶带、剥离表面保护胶带时,有时会出现芯片错位(切割槽偏移)。如果芯片的错位量很大,则有可能无法确保正确的刀片切割道。 - 刀片的刃宽
因为需要比切割槽宽度(芯片间的距离)更薄的刀片,所以加工要求很高。 - 加工速度
为了保证切割后DAF有良好的质量,有时难以进行高速加工。
但是,采用在DBG加工后利用激光切割DAF的应用技术,则可以解决加工时芯片错位的问题,并能提高加工速度。
DBG+DAF激光切割的工艺
将DBG加工后的晶片转放到框架上,剥离掉表面保护胶带后,从晶片表面一侧对DAF进行全切割。晶片已经分离成了芯片,所以就可以从芯片间照射激光,只将DAF切断。
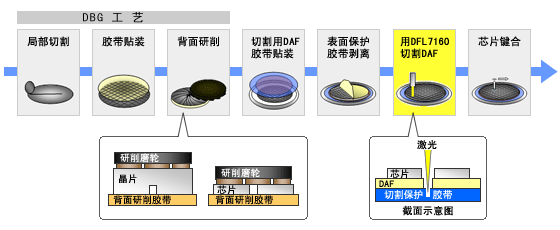
DAF激光切割的优点
可改善DAF的加工质量
采用激光切割技术可以抑制采用磨轮刀片切割DAF时产生的毛边。
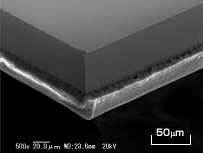
能够进行高速切割,提高生产效率
与磨轮刀片切割相比,可以提高DAF全自动切割时的加工速度。
加工实例:加工进给速度100 mm/sec ~ 300 mm/sec,以1pass进行DAF切割(加工条件因DAF的种类、DAF的厚度、晶片厚度和切割槽宽度等的不同而有所变化。)
利用特殊校准,可以解决芯片错位问题
即使在DBG加工后的晶片上出现了芯片错位,也能够通过采用特殊校准进行跟随芯片错位的加工。根据各加工线上的每个校准点,记忆切割槽中心的位置,并用激光对其中心进行切割。



