DBG + DAF雷射切割
解決方案
DBG(Dicing Before
Grinding)*1製程利用研磨來分割晶片,故能夠降低背面崩裂,並能因此提高晶片抗折強度。另外,因為是在研磨結束階段分割成晶粒,所以有望在加工薄形晶片時減小晶片破損的風險。今後如能在這種DBG製程中採用DAF(Die
Attach Film)*2的話,也有可能在SiP(System in Package)等薄型晶片積層的封裝製造方面全面採用DBG製程。
在DBG製程中採用DAF時,需要在分割成晶粒的晶片的背面貼上DAF,並再次將DAF單獨切割。這次我們向大家介紹利用雷射全切割進行這種DAF切割的應用技術。
*1 DBG(Dicing Before Grinding):這種技術將傳統的“背面研磨→晶片切斷”的製程倒過來,先將晶片半切割,然後利用背面研磨進行晶片分割。
*2 DAF(Die Attach Film):這是一種薄膜狀的接合材料,用於薄型晶片積層等。
應用技術
在DBG加工後,用刀片來切割DAF時,目前以下幾個方面的課題有待解決。
DBG製程中利用刀片切割DAF時的課題
- 晶粒的整列性
粘貼切割膠帶,剝離表面保護膠帶時,有時會出現晶粒錯位(切割槽偏移)。如果晶粒的錯位量很大,則有可能無法確保有良好的刀片切割通路。 - 刀片的刃寬
因為需要比切割槽寬度(晶粒間的距離)更薄的刀片,所以要求加工時要很小心。 - 加工速度
為了保證切割後DAF有良好的品質,有時難以進行高速加工。
但是,採用在DBG加工後利用雷射切割DAF的應用技術,則可以解決加工時晶粒錯位的問題,並能提高加工速度。
DBG+DAF雷射切割的製程
將DBG加工後的晶片轉放到架上,剝離掉表面保護膠帶後,從晶片表面一側對DAF進行全切割。晶片已經分離成了晶粒,所以就可以從晶粒間照射雷射,只將DAF切斷。
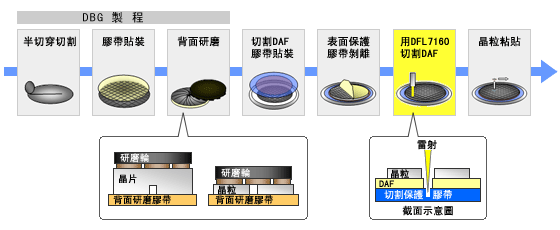
DAF雷射切割的優點
可改善DAF的加工品質
採用雷射切割技術可以抑制採用刀片切割進行DAF切割時產生的毛邊。
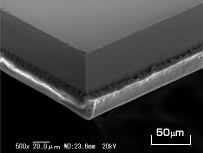
(70 µmSi + 20 µmDAF)
能夠進行高速切割,提高生產效率
與刀片切割相比,可以提高DAF全切割時的加工速度。
加工實例:加工進給速度100 mm/sec ~ 300 mm/sec,以1pass進行DAF切割
(加工條件因DAF的種類,DAF的厚度,晶片厚度和切割槽寬度等的不同而異。)
利用特殊排列校準功能,可以解決晶粒錯位問題
即使在DBG加工後的晶片上出現了晶粒錯位,也能夠通過採用特殊排列校準功能進行跟隨晶粒錯位的加工。可就各加工線上的每個排列對位點,記憶切割槽中心的位置,並用雷射對其中心進行切割。



