Wet Polishing(CMP等)
解决方案
对于Silicon Device,伴随着IC Package扁平化,小型化的发展,内置芯片也越来越薄,为了提高其强度,晶圆背面研削后需进行应力释放。此外,诸如用于高亮度LED的蓝宝石衬底(Al2O3),用于高速通信设备SAW滤波器的钽酸锂衬底(LiTaO3)/铌酸锂衬底(LiNbO3),以及用于功率器件的碳化硅衬底(SiC)等等,都需要在背面研削后进行抛光,以提高Device性能。
一般的CMP (Chemical Mechanical Polishing)设备是把晶圆置于上方,抛光Pad置于下方,相比之下,迪思科的设备则是把抛光Pad置于上方,晶圆放置在下方的配置,因持有进给轴的构造所以被命名为“Infeed Polishing进给式抛光”,应用于Dry Polishing(干式抛光)和Wet Polishing(使用以CMP为代表的药液湿法抛光)。本期向您介绍的迪思科Wet Polishing可减少加工物表面的划痕,并提高镜面效果和清洁度。另外,根据材料不同,也可达到Epi Ready*1的效果。
*1 Epi Ready:可对应Epitaxy外延的面,材料
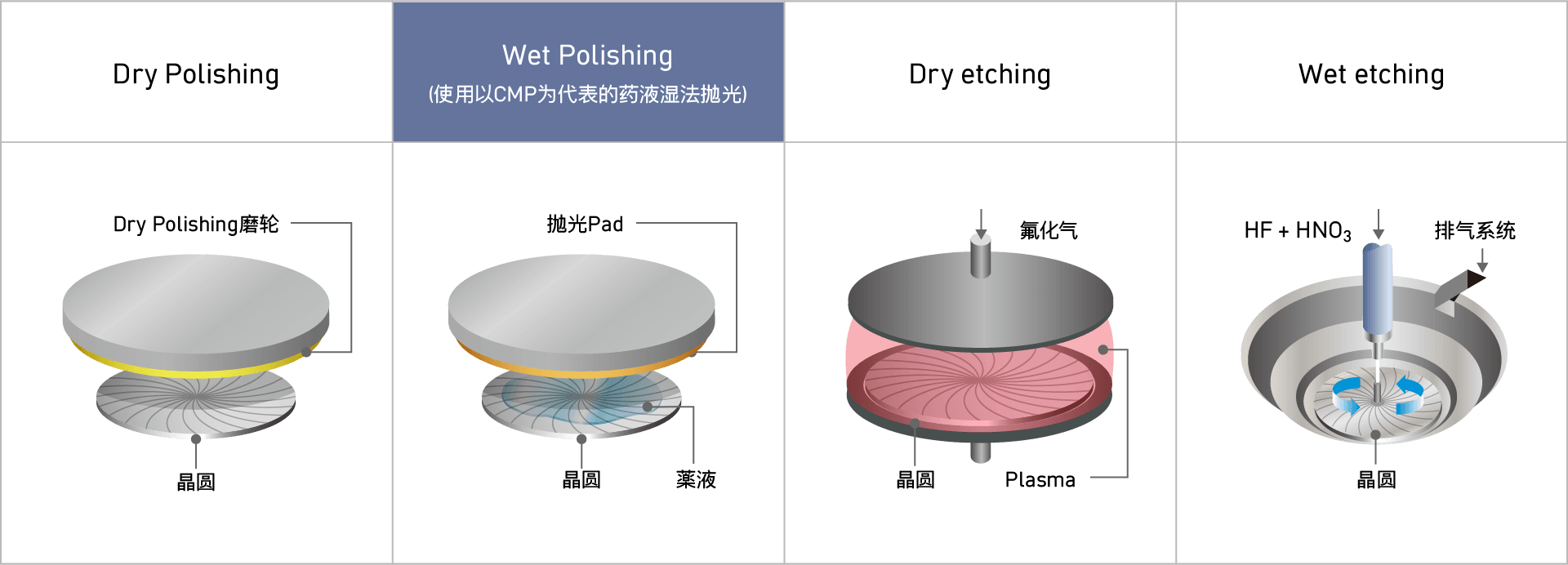
Wet Polishing工序的特点
- 低负载,高转速的抛光
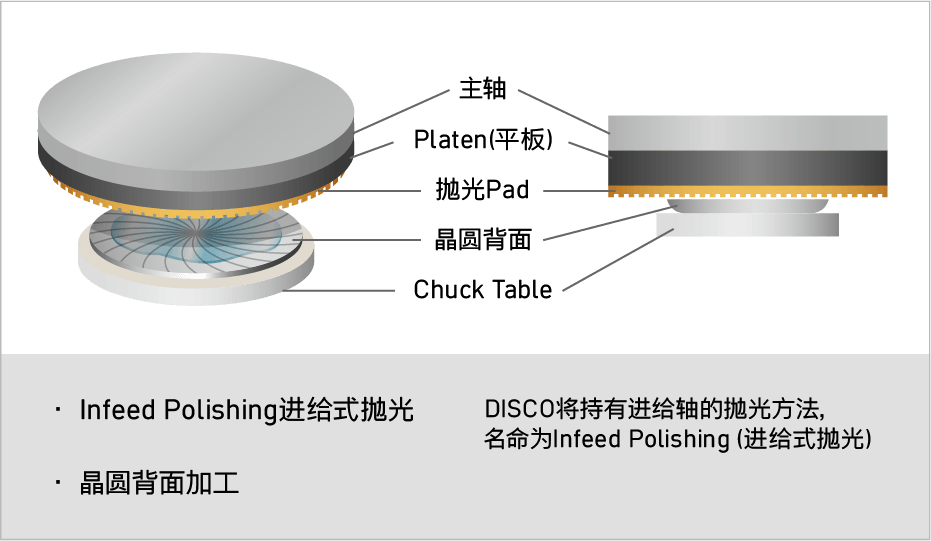
Wet Polishing工序的主要效果
- 镜面加工
- 高清洁度
- 根据素材不同,能够减少划痕,可达到Epi Ready效果
应用案例
-
晶圆制造(衬底的制造工序)抛光
- Silicon carbide(SiC)
- Sapphire(Al2O3)
- Lithium tantalite (LiTaO3) / Lithium niobate(LiNbO3)
-
研削后的应力释放
- Silicon(Si)
- Sapphire(Al2O3)
- 钽酸锂(LiTaO3) / 铌酸锂 (LiTaO3) on 硅(Si)
- Gallium arsenide(GaAs)
- Indium phosphide(InP)
- Cu-Cu键合前抛光
- 硅(Si)晶圆的再生加工

对应设备
我们的产品阵容具备高度可扩展能力,可匹配用户不同的操作环境,并可实现广泛应用。




