何謂隱形切割TM加工?
隱形切割係將雷射聚光於工件内部,在工件内部形成變質層,通過擴展膠膜分割晶粒的切割法
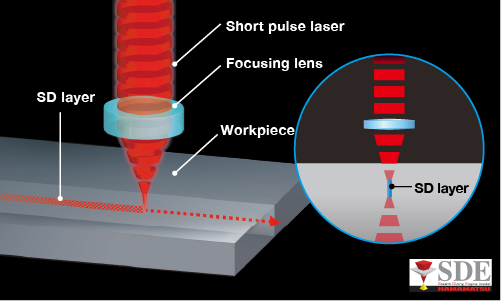

-
擴展膠膜前
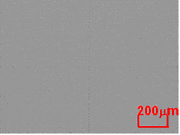
-
擴展膠膜後
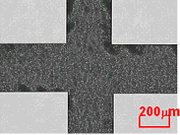
DISCO為隱形切割技術專利持有者濱松光子學股份有限公司的聯盟夥伴*。
*獲得隱形切割技術相關的專利資訊授權的相關業務夥伴,系統整合商
https://www.hamamatsu.com/jp/en/product/semiconductor-manufacturing-support-systems/stealth-dicing-technology/alliance-partners.html
隱形切割TM加工的優點
- 由於工件内部變質,因此可以抑制加工屑的產生。適用於抗污能力差的工件
- 適用於抗負荷能力差的工件(MEMS等),且採用不需清洗的乾式加工製程
- 可縮小切割道寬度,對於減小晶粒間隔十分有貢獻
隱形切割TM加工的事例
MEMS切割
在裝有複雜微小元件的晶粒及存在中空部結構的晶粒等MEMS晶粒的切割中,通常晶粒對清洗水及加工負荷的承受能力不強。而隱形切割在加工、清洗時不使用水,且對於晶粒正反面基本上無損傷,因此可期待高品質的MEMS加工。
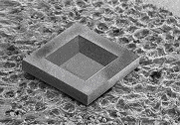
縮小切割道
由於隱形切割可縮小切割道寬度(切割寬度),因此,與一般的切割相比,可期待增加單一晶圓内的晶粒可得個數。特別是線性感應器等長形晶粒尤其有效。
晶粒製造個數模擬
通過減小晶粒間隔,增加由晶片製造長形晶粒個數的示例

Hasen切割
所謂的Hasen切割,是在雷射加工中,根據事先設定的周期重複雷射光的ON/OFF,進行切割的方法。依據ON/OFF設定不同,可以加工為各種形狀。
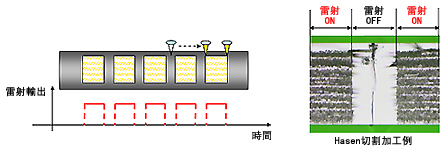
Hasen切割的應用例
- 具有規則性尺寸的複合晶粒的晶片切割
利用Hasen切割,可實現一般的雷射切割及傳統切割中所無法達到的單一晶圓中的不規則晶粒切割。
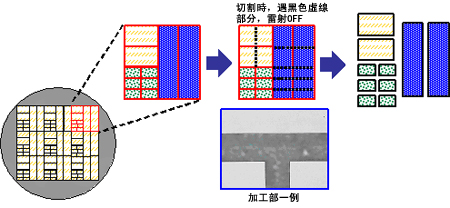
- 異形晶粒的加工
可加工為6邊形、8邊形・・・等多邊形晶粒,且沒有浪費。根據條件,還可加工為非正多邊形晶粒。
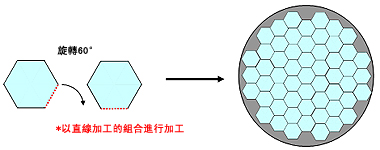

- 晶粒偏移加工
如下圖所示,Hasen切割還適用於割道不連續的晶粒佈局。因此,尤其是在單一大且價格昂貴的晶粒、及長形晶粒等,可有效的在晶片上增加晶粒可得數。
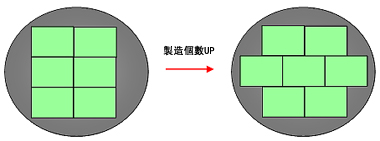
分離擴片機的晶粒分割
晶粒擴片機是透過使切割膠帶擴張撐大,將被隱形切割後形成變質層的晶圓分割成晶粒的裝置。
首先將隱形切割後的晶圓在冷擴張台進行含膠帶的擴張分割。之後在熱擴張台用200度C以上的高溫將膠帶加熱,使其熱收縮(heat shrinking)消除膠帶外圈所產生的鬆弛。
透過上述製程,不需更換膠帶,可直接將鐵圈搬送到下一個製程。





