초박형 웨이퍼 마무리 연삭(Ultra-Thin Grinding)
솔루션
최근 휴대폰 등의 디지털 모바일기기에 사용되는 SiP(System in Package)등의 보급에 따라, 100 µm 이하의 웨이퍼 두께로 제품의 효율을 좋게 실현하는 박화 연삭기술이 주목 받고
있습니다. DISCO에서는 다양한 장치・절삭가공 툴・연삭조건의 조합으로 고객에게 맞는 최적의 조건을 제안하고 있습니다.
DISCO의 최신 박화(Thinning) 마무리 연삭기술을 소개합니다.
어플리케이션 사례
사진1은 Φ300 mm 실리콘 웨이퍼를 연삭만으로 두께 5 µm까지 박화(Thinning)한 것입니다. 이번에 소개하는 장치・절삭가공 툴・연삭조건을 최적화함으로써, 종래의 연삭만으로도 이와같이 얇게 가공할 수 있습니다.

장치
박화(Thinning)연삭시의 장치상의 대응으로는, 박화(Thinning)에 의해 기계적 강도가 떨어져 굉장히 깨지기 쉬운 웨이퍼를 어떻게 안전하게 핸들링이 가능할지가 포인트가 됩니다.
반송계에서는 웨이퍼와 동일 지름의 반송 패드(사진2)를 사용하는 한편, 웨이퍼와 패드 사이에 파티클이 끼지 않도록 패드면을 세정하는 기능등을 채용하고 있습니다. 또한, 사람의 손을 최대한
사용하지 않고 그라인딩에서 DAF점착, 웨이퍼 마운트, 표면보호 테이프 박리까지 일관하여 대응하는 인라인(In-line)시스템(사진3)도 웨이퍼 파손 저감에 효과적인
해결 방법입니다.


(DGP8761+DFM2800)
휠(Wheel)
종래의 1축 Rough grinding용 휠로 사용되어 왔던 비트리파이드 본드(VS, VS202등)에서 레진 본드BT100(사진4)로 변경하여 저 데미지를 꾀하고,
웨이퍼 파손의 원인이 되는 엣지 칩핑*1을 억제할 수 있습니다. 또한, 2축의 마무리 연삭용 휠에는 1축에서의 연삭 데미지 제거를 위한 연삭량 증가에 대응한
BK-09본드를 사용하여 드라이 폴리싱 등의 스트레스 릴리프 처리를 하지 않고 초박형 웨이퍼 마무리 연삭(Ultra-Thin Grinding)이 가능합니다(사진5).
또한, Rough Grinding에 BT100, 마무리 연삭에 초미세 연마용 입자를 사용한Poligrind(사진6)을 사용하여 Φ8인치
웨이퍼는 물론 대부분 스트레스 릴리프가 필요하였던 Φ300 mm웨이퍼의 초박형 웨이퍼 마무리 연삭(Ultra-Thin Grinding)이 연삭가공만으로 가능하게 되었습니다. Poligrind는 종래의 마무리 연삭 휠을 갈아 끼우는
것만으로 3축의 장비뿐만 아니라 2축의 장비에서의 초박형 웨이퍼 마무리 연삭(Ultra-Thin Grinding)이 가능합니다.



※1 웨이퍼의 엣지부분의 절단형상은 R형상으로 되어 있지만, 웨이퍼를 얇게 하면 이 R엣지부분이 샤프한 형상이 되며 기계적인 강도가 상당히 약해집니다. 연삭수의 영향이나 가공조건등에 따라 엣지부분에 버(Burr) 혹은 칩핑이 발생하여 웨이퍼 파손의 원인이 됩니다(그림1).
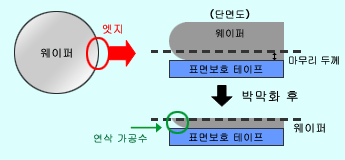
연삭조건/어플리케이션

연삭조건에 관하여는 Rough grinding, Finishing grinding 모두 휠(Wheel)축의 공급속도를 최종 마무리 두께 부근에서 저속화하여 저부하 연삭이 가능합니다.
또한, 엣지 칩핑 저감대책으로서는 휠축의 회전속도를 저속화하면서 웨이퍼 흡착 테이블쪽을 고속화하는 등의 어플리케이션이 효과적입니다.
엣지 칩핑 저감대책의 또 다른 솔루션으로서는 엣지 트리밍(사진7)이라는 방법이 있습니다. 이것은 연삭가공 전에 미리 웨이퍼 엣지부에 홈 형성을 해 두고 웨이퍼의 박화(Thinning) 후에 엣지가
샤프한 형상이 되지 않도록 하는 프로세스이며, 상당량의 엣지 칩핑 저감이 실현 가능 합니다.
-
웨이퍼 엣지부
엣지 트리밍한 경우
-
웨이퍼 엣지부
엣지 트리밍하지 않은 경우
항절 강도의 향상 (스트레스 릴리프)
Poligrind를 사용함으로써 연삭에 의한 박화 마무리의 가공품질도 향상되고 있지만, 휠(Wheel)에 의한 가공이므로 아주 적지만 웨이퍼 표면에 파괘층이 남습니다. DISCO에서는 이 파괘층을 제거하여 칩 항절 강도를 더욱 향상시키는 스트레스 릴리프 기술에 대해서도 고객의 요구에 맞게 다양한 프로세스를 제공할 수 있습니다(표1).
| 드라이 에칭 | 불소계 가스에 의한 플라즈마 에칭을 실시하는 스트레스 릴리프 프로세스입니다.DBG※2와 조합하면, 칩 측면의 스트레스 릴리프도 가능합니다. |
|---|---|
| 드라이 폴리싱 | 드라이 폴리싱 휠을 사용하여 물이나 약품을 일절 사용하지 않는 건식 스트레스 릴리프 프로세스입니다. |
표1. DISCO의 스트레스 릴리프
※2 DBG (Dicing Before Grinding)란 먼저 웨이퍼를 하프 커팅한 후, 표면 연삭으로 칩을 분할하는 기술입니다. 웨이퍼 warpage의 영향을 받지 않고 표면 칩핑도 큰 폭으로 저감합니다.
문의
질문・상담이 있으시면 언제든 문의해 주십시오.

